レーザー加工の分類Laser Processing Classification
レーザー加工は、レーザー光が加工対象物に作用することで生じる「物理現象」と捉えることができます。その結果として得られる「効果」により下記のように分類されます。
レーザー加工は、「除去」ばかりでなく、「接合」にも活用することができます。また、大きな形状変化を伴わずに加工対象物の機能や特性を変化させる「改質」も行うこともできます。

レーザー加工の特長Advantages of Laser Processing
レーザー加工には、他の加工技術に対し下図のような特長があります。
光の振る舞いは独特で、物質を透過する、物質界面で曲がる・折れる、物質の後ろ側に回り込む、拡がる等、伝播中に様々な挙動を示すため、馴染みのないお客様にとっては特性を把握しがたい側面があります。
LaSでは、これらの光の特性を熟知するエンジニアが中心となり、プロセスの開発を行っています。
-
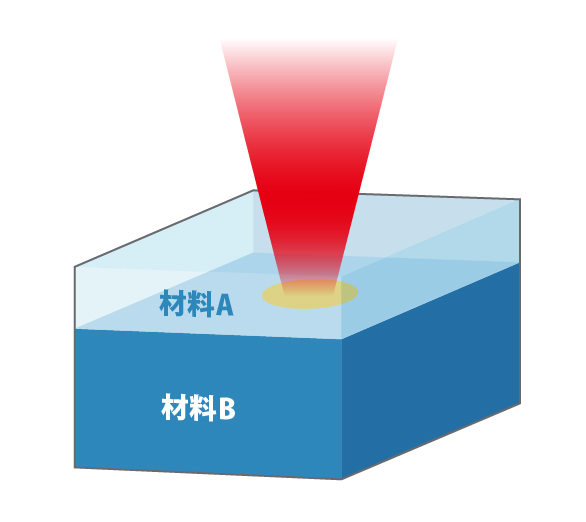
非接触加工ツールの接触・摩擦がない
局所微細加工極めて選択的な加工が可能
材料越しの加工が可能(透明性を有する材料の場合)
-

高速走査可動ミラーで反射させることで高速走査が可能
異形・任意形状加工
-

内部加工物質表面を透過して内部へ直接加工することが可能(集光点でのみ加工される)
-
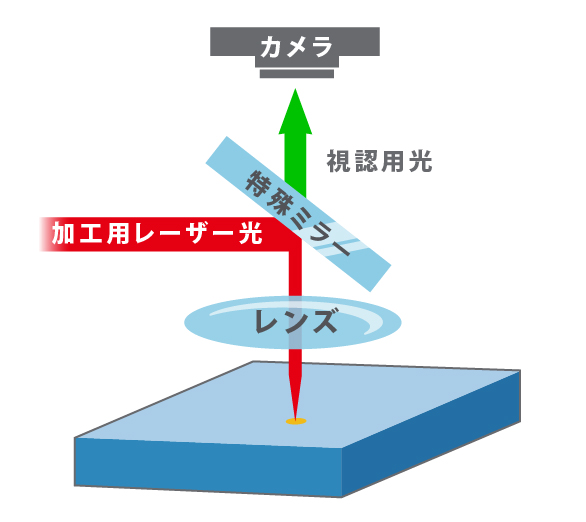
同軸観察カメラで加工点を直接観察しながらの加工が可能(加工と検査が同時に可能)
加工事例Laser Processing Examples
無機材料
-
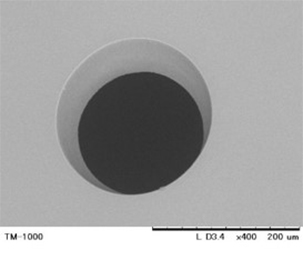
材料: サファイア(t=85μm) 加工: 貫通穴加工 寸法: φ200μm 速度: ~3.8秒/穴 ※上写真のφ200μm穴の拡大写真
-
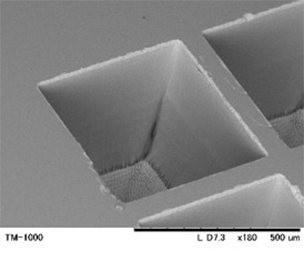
材料: Si (t=630μm) 加工: 矩形掘削加工 寸法: □500μmエリア
掘削深さ300μm
隔壁100μm速度: ~29秒/穴 -
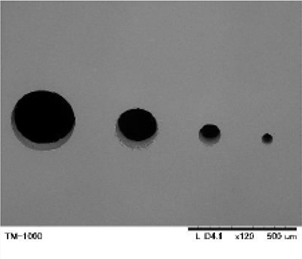
材料: サファイア(t=85μm) 加工: 貫通穴加工 寸法: 左から順に
φ300μm
φ200μm
φ100μm
φ50μm -
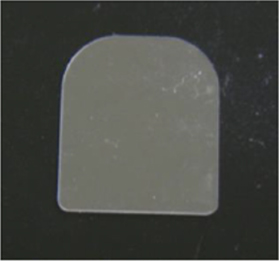
材料: サファイア(t=200μm) 加工: 切断加工 寸法: φ200μm(下端両角) -

材料: Si 加工: 表面パターニング 寸法: □15mmエリア
192pix × 192pix
ドットピッチ=80μm(XY)
ドットサイズ=φ20μm時間: ~3秒 -

材料: SiC(t=350μm) 加工: スクライブ(溝)加工 寸法: 溝幅=約15μm
溝深=約25μm速度: 300mm/s
有機材料
-
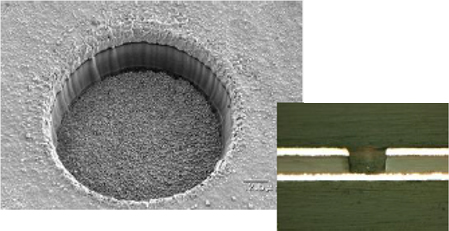
材料: 両面銅箔付プリント基板(t=50μm) 加工: ブラインドビア加工 寸法: φ50μm -
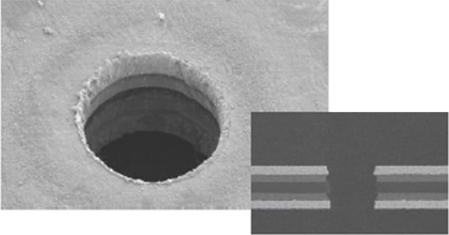
材料: 両面銅箔付プリント基板(t=50μm) 加工: スルービア加工 寸法: φ50μm -

材料: ポリイミドフィルム(t=25μm) 加工: 外形切断加工 -
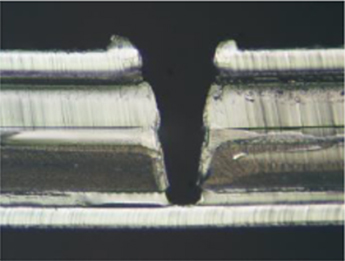
材料: 積層フィルム 加工: ハーフカット加工 -
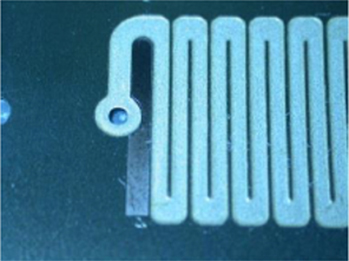
材料: 機能性フィルム 加工: 表面パターニング加工 -
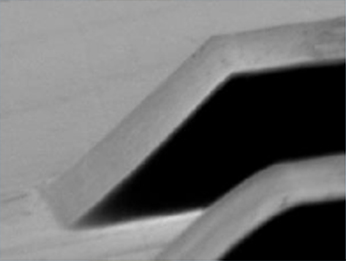
材料: プラスチック導波路 加工: 45°ミラー加工






